Intel ускоряет развитие инноваций, активно внедряя новые подходы к гибридной архитектуре процессоров и технологиям компоновки. На выставке CES 2019 компания рассказала о новом процессоре под кодовым названием Lakefield, для изготовления которого впервые используется новая технология 3D-компоновки Foveros. Представленный гибридный дизайн Lakefield предполагает объединение в едином чипе большого ядра семейства Core и четырёх маленьких ядер Atom.

По замыслу разработчиков, такая комбинация должна функционировать подобно многим мобильным чипам с технологией ARM big.Little, где различные по характеристикам ядра ответственны за решение различных задач в зависимости от их требований к вычислительным ресурсам, что позволяет оптимизировать производительность, энергопотребление и тепловыделение.

Применение технологии 3D-компоновки Foveros в данном случае позволяет собрать несколько независимых кристаллов на единой активной полупроводниковой подложке, что даёт возможность упростить производственный процесс и получить итоговый чип с минимальной площадью. Однако необходимо уточнить, что разнородные ядра в конструкции Lakefield располагаются в одном 10-нм полупроводниковом кристалле.
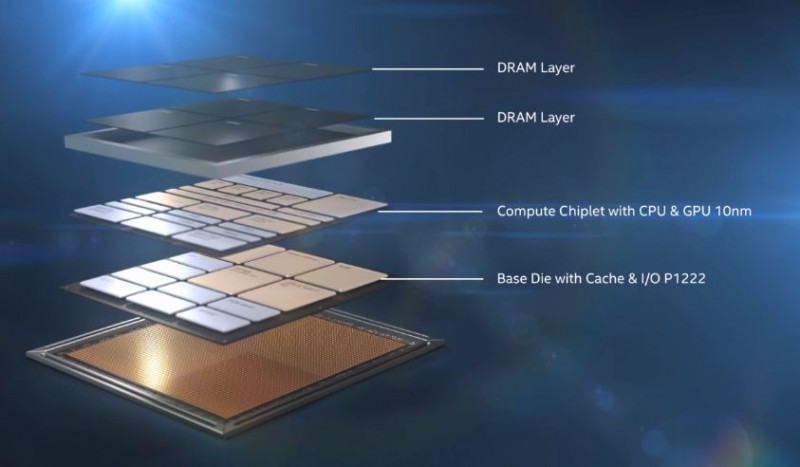
3D-компоновка в данном случае применена для комбинирования 22-нм подложки с 4 Мбайт кеш-памяти третьего уровня и набором системной логики, 10-нм «вычислительного» чиплета с ядрами и графическим ядром, и слоя с кристаллами LPDDR4-памяти общей ёмкостью 8 Гбайт.
